硅是半导体材料,在无杂质的情况下,其自身的导电性能很弱,晶体内的杂质与晶体缺陷是影响其电学性能的主要因素。由于FZ硅单晶纯度很高,想要获得一定的电学性能,必须掺入一些杂质,以提高其电活性。多晶硅原料中杂质含量与类型,掺杂单晶硅的电学性能,都是影响其掺杂物质与掺杂量的重要因素。然后通过计算与实际测量,修正拉制参数,最后得到高品质单晶。FZ硅单晶的主要掺杂方法有核心掺杂法、溶液涂敷掺杂法、填装掺杂法、中子嬗变掺杂法(NTD)和气相掺杂法等。
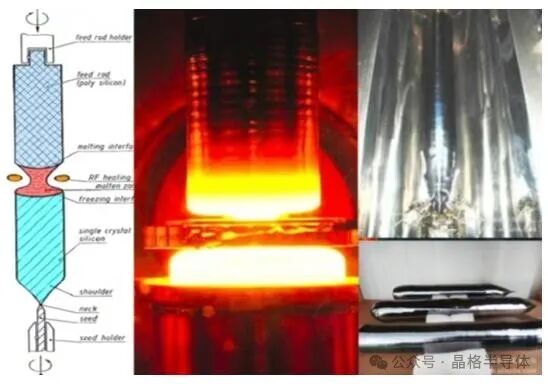
一、核心掺杂法
这种掺杂技术是将整根原料棒中混入掺杂物。我们知道原料棒是利用CVD方法制造出来的,因此制造原料棒所使用的晶种,可以使用已经含有掺杂物的硅晶体。当拉制硅单晶时,已经含有大量掺杂物的晶种与晶种外包裹纯度较高的多晶共同熔化混合,杂质能够通过熔区旋转搅拌,均匀的掺入单晶硅中。但是这样拉制的单晶硅电阻率较低。所以控制电阻率需要利用区熔提纯的技术,控制多晶原料棒中掺杂物的浓度。例如:要降低多晶原料棒中掺杂物的浓度,必须增加区熔提纯的来回次数。使用这种掺杂技术,比较不易控制品棒的轴向电阻率均匀度,所以一般只适合用在偏析系数较大的硼上。因为硼在硅中的分凝系数为0.8,使得掺杂过程中分凝效应影响低,电阻率容易控制,所以硅芯掺杂法特别适合于掺硼工艺。
二、溶液涂敷掺杂法
溶液涂敷法顾名思义是将含有掺杂物质的溶液涂敷在多晶原料棒上。当多晶熔化时,溶液蒸发,将掺杂物混入熔区,最后拉制成硅单晶。目前主要的掺杂溶液是三氧化二硼(B2O3)或五氧化二磷(P2O5)的无水乙醇溶液。按照掺杂类型和目标电阻率控制掺杂浓度和掺杂量。此方法存在很多弊端,如不易定量控制掺杂物,掺杂物分凝以及掺杂物在表面分布不均匀导致电阻率均匀性差等。
三、填装掺杂法
此方法比较适合用在分凝系数低及挥发性低的掺杂物如Ga(k=0.008)及In(k=0.0004)。这种方法是在原料棒上接近圆锥部分钻一个小洞,再把Ga或In 塞在洞中。由于掺杂物的分凝系数很低,在生长过程中熔融区内的浓度几乎不会减少太多,因此生长出的单晶硅棒轴向电阻率均匀性好。含这种掺杂物的单晶硅主要用于红外探测器的制备。所以,在拉制过程中,对过程控制要求很高。包括多晶原料、保护气体、去离子水、清洗用的腐蚀液,掺杂物的纯度等。拉制过程中也要尽可能的控制过程污染。防止线圈打火、塌硅等现象出现。
四、中子嬗变掺杂(NTD)法
中子照射掺杂(Neutron transmutation doping,简称NTD)。利用中子照射掺杂(NTD)的技术,可以解决N型单晶里电阻率不均的情形。在自然的硅中,含有约3.1%的同位素30Si。这些同位素30Si在吸收热中子(thermalneutron)亦释放一个电子之后,可转换成31P。
随着中子动能进行的核反应,使得31Si/31P原子由原来的晶格位置偏离一小距离,而引起晶格缺陷。大部分的31P原子被局限于插入型晶格内(interstitialsites),在这插入型晶格位置,31P原子是不具备电子活化能的。但是将晶棒在约800℃做退火处理,可使得磷原子回到原来的晶格位置。由于大部分中子可以完全通过硅的晶格,使得每一个Si原子有相同的几率可以捕捉到中子,而转换成磷原子。于是,31Si原子可以很均匀的分布在晶棒中。
五、气相掺杂法
这种掺杂技术是将易挥发的PH3(N-type)或B2H6(P-type)气体直接吹入熔融区,这是目前最普遍使用的掺杂方法。所使用的掺杂气体必须借助 Ar 气体稀释后再通入熔融区内。通过稳定控制充气量,并将熔区内的磷的蒸发量忽略,可以将熔区内的掺杂量稳定,进而能够稳定控制区熔单晶硅的电阻率。不过由于区熔炉的体积大,保护气体 Ar的含量高,所以要进行预掺杂。使炉体内的掺杂气体浓度尽快达到设定值,进而稳定控制单晶硅的电阻率。