什么是玻璃通孔(TGV)技术
时间:2025-08-08 发布人:admin 点击数:0
玻璃通孔(TGV,Through Glass Via)技术是一种在玻璃基板上制造垂直贯穿通孔的先进封装技术,通过微米级精密加工实现芯片间的高效电气互连,被誉为下一代三维集成的核心技术。其核心原理是利用激光刻蚀或湿法腐蚀在玻璃基板上形成高深宽比通孔,再通过金属化填充(如电镀铜)构建垂直导电通道,从而在三维空间内实现高密度信号传输。
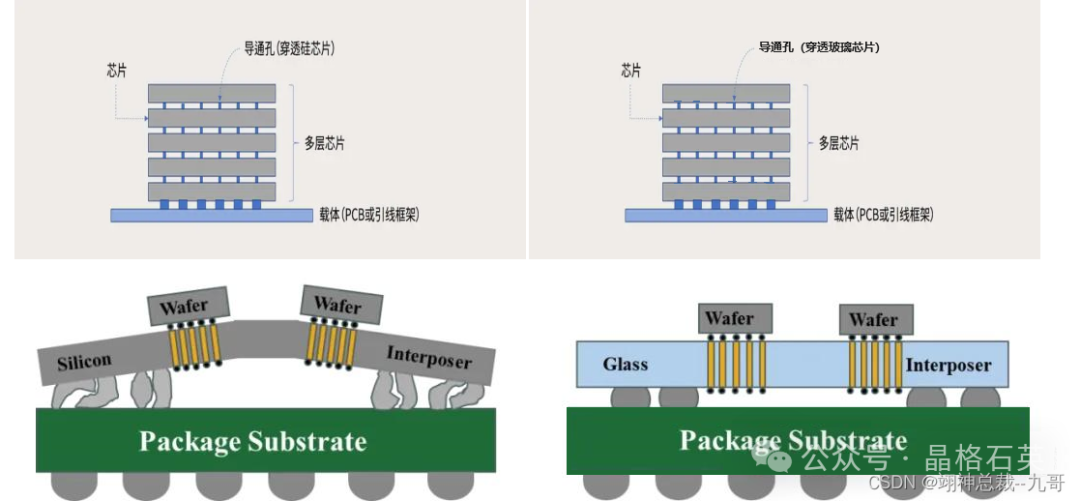
一、技术特性与优势
高频性能卓越
玻璃材料的介电常数仅为硅的 1/3(约 3.8 vs 11.9),损耗因子低 2-3 个数量级,在 5G 毫米波通信中信号损耗可减少 30%,显著提升射频模块的信号完整性。例如,厦门大学团队利用 TGV 技术制备的毫米波封装天线,通过 5 层玻璃晶圆堆叠实现了低损耗信号传输,满足 6G 通信对高频器件的严苛要求。热机械稳定性突出
玻璃的热膨胀系数(CTE)可定制在 3-5ppm/℃,与硅芯片高度匹配,有效避免高温封装时的翘曲问题。即使在厚度小于 100μm 的超薄基板上,TGV 技术仍能将翘曲控制在极小范围,确保芯片堆叠的长期可靠性。成本与工艺优势显著
玻璃基板成本仅为硅基的 1/8,且无需沉积绝缘层,工艺流程缩短 30% 以上。例如,武汉帝尔激光研发的玻璃通孔激光设备,通过皮秒激光与湿法刻蚀联用,实现了径深比 1:100 的微孔加工,加工效率达 290 孔 / 秒,大幅降低量产成本。
二、关键制造工艺
微孔加工技术
激光诱导刻蚀(LIDE)
通过超短脉冲激光在玻璃内部形成改性区域,再经氢氟酸湿法刻蚀形成通孔。该工艺可实现直径 10μm、深宽比 1:15 的微孔,表面粗糙度控制在 0.1μm 以内。 超快激光 + 湿法腐蚀
美迪凯采用该技术实现了最小 10μm 孔径的盲孔 / 通孔加工,成功应用于多层玻璃基板堆叠的 AI 芯片封装。
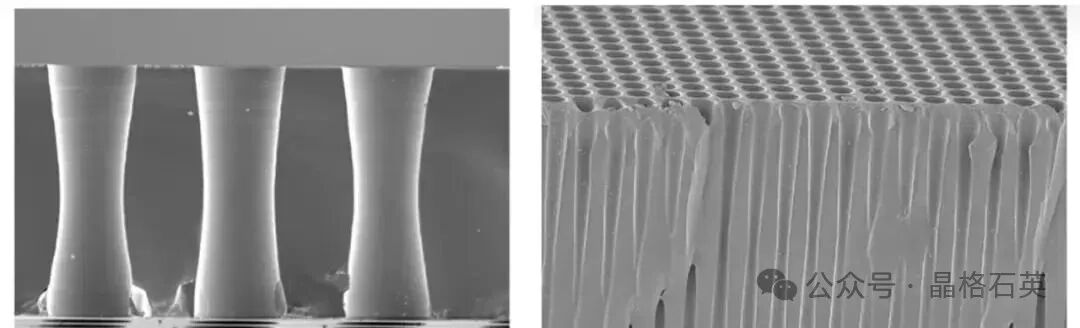
金属化与填充方案
电镀填实
通过自底向上脉冲电镀技术,结合纳米级种子层优化,通孔填充率超 99.9%,确保低电阻互连。 金属导电胶
利用可调热膨胀系数的导电胶填充,可有效缓解玻璃与金属的 CTE 失配问题,适用于柔性封装场景。 晶圆级集成工艺
苏州科阳半导体开发的 TGV 基板集成封装技术,通过玻璃基板减薄、通孔互连与塑封体集成,实现了芯片高密度封装,同时降低了玻璃隐裂风险。
三、核心应用领域
先进芯片封装
2.5D/3D 集成
TGV 技术作为中介层,可实现 Chiplet 间的高密度互连。例如,英特尔计划 2026 年将 TGV 基板用于数据中心芯片,通过玻璃中介层实现 HBM 与 CPU 的低延迟连接,带宽提升 6 倍。 AI 芯片
美迪凯开发的 TGV 工艺支持 3D Chiplet 堆叠,解决了 AI 芯片对高带宽(>1TB/s)和低功耗的需求,已应用于边缘计算芯片封装。 射频与通信
5G/6G 射频模块
玻璃的低介电损耗特性使其成为毫米波天线封装的理想选择。Menlo 公司采用 TGV 技术实现了射频芯片的超小型晶圆级封装,体积缩小 50%。 光电子集成
玻璃的透明特性支持光互连模块集成,英特尔在数据中心芯片间实现了 800Gbps 光信号传输,延迟降低 40%。 MEMS 与传感器
真空封装
TGV 技术可通过玻璃通孔实现 MEMS 器件的气密封装。挪威 Sensonor 公司采用玻璃回流 TGV 技术封装硅微陀螺,应力降低 60%,灵敏度提升 30%。 生物医疗
TGV 基板的高绝缘性和耐腐蚀性,使其在植入式医疗设备传感器封装中具有独特优势。



