在科技飞速发展的当下,电子材料领域不断涌现新的突破,碳化硅(SiC)便是其中的一颗璀璨明星。作为一种理想的电子材料,SiC在高温、高频、大功率电子器件中的应用需求与日俱增。而SiC器件的加工离不开SiC外延膜,这就使得SiC外延设备在整个产业链中占据着举足轻重的地位。
一、挑战重重:SiC外延设备的研究难点
SiC外延设备的复杂性超乎想象,反应室设计、加热系统和旋转系统等关键部件的精确控制,都是科研人员需要攻克的难关。在SiC外延生长过程中,晶型夹杂和缺陷问题频发,严重影响外延膜的质量。如何在提高外延生长速率和品质的同时,有效避免这些问题的产生,成为了研究道路上的关键挑战。
二、工艺基石:SiC - CVD外延工艺基础
SiC - CVD外延工艺基于化学气相沉积法,通过精准控制反应气体流量,让气体均匀抵达生长面,从而在SiC晶圆表面生成SiC薄膜。值得一提的是,SiC具有多种晶体结构,其中4H - SiC是主流器件采用的晶型材料。在这个过程中,反应室设计必须避免湍流形成,防止局部预反应生成其他晶型。而快速SiC外延工艺更是一大突破,通过加入HCl气体或使用含Cl化合物,实现了高达112μm/h的高质量快速外延生长,不仅抑制了Si团簇的生成,还提高了Si源利用效率,加快了生长速率。
三、关键部件:技术进展大揭秘
反应室系统:SiC - CVD反应室设计有着严格要求,无返混、气体瞬时切换、晶圆上方层流区、温场和流场分布均匀等缺一不可。热壁CVD反应室通过增加绝热材料,提升了加热效率,降低了法向温度梯度,让晶圆反应面温度更均匀。虽然对SiC - CVD反应室的模拟研究较少,但从MOCVD反应室模拟研究可知,反应室高度和旋转速度对流场均匀性有影响,活塞流是最有利的理想流型。

加热器和温控系统:在SiC - CVD设备中,电阻式加热器因温度均匀性好、控制方便被广泛应用。石墨加热器凭借高导热性、导电性、良好的加工性能和相对较低的价格,也越来越受青睐。同时,设备需要精确的分阶段控制加热过程,1300℃以下通常用热电偶测温,1300℃以上采用红外测温,以实现快速平稳升温并稳定保持在生长温度。
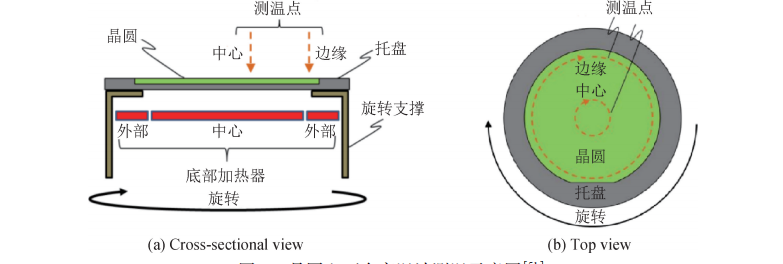
高速旋转设计:能显著降低掉落物缺陷率,延长维护间隔时间。现有气浮旋转和中心轴支撑旋转两种技术,二者结合可有效提高均匀性。气浮旋转利用气体的浮力使旋转部件悬浮,减少了机械摩擦和振动,能够实现更高的转速和更稳定的旋转;中心轴支撑旋转则提供了更可靠的机械支撑,保证旋转的精度。将两者结合,在高速旋转时利用气浮的优势减少振动,在低速或启动停止阶段依靠中心轴支撑保证稳定性,从而提高了外延膜的均匀性。
晶圆传送系统:晶圆传送系统由载片盒、传送腔和机械手组成,高温传盘能大幅缩短反应周期,提升生产率。载片盒用于存放待加工的SiC晶圆,传送腔需要保持洁净的环境,防止灰尘等杂质污染晶圆。机械手的动作精度和速度直接影响着传送效率,高温传盘技术采用特殊的耐高温材料和隔热设计,使晶圆在高温状态下就能快速传送至下一工序,减少了冷却和再升温的时间,大大提高了生产效率。
四、国际国内:现状与展望
国际上,意大利LPE、德国Axitron和日本NuFlare的SiC - CVD设备已实现商业化量产。而国产设备在使用方便性、可调性、稳定性以及运行维护性方面,与国外先进设备还有差距,重点需要提升温场和流场的均匀性。
SiC - CVD设备技术发展的趋势是优化生长速度、均匀性和掺杂均匀性。未来研究重点包括反应室模拟和实验验证、结合工艺创新得到更高生长速率、应对小尺寸到大尺寸的演变以及提升生产效率。


