碳化硅,作为极具潜力的第三代半导体,凭借其卓越性能在众多关键领域展现出广阔应用前景。SiC的带隙约为硅的3倍,这使其在高温环境下能保持稳定的电学性能,减少电子的热激发,降低器件的漏电电流,提高器件的可靠性和稳定性。临界击穿场强高达硅的10倍,意味着SiC器件能够承受更高的电压,在高压电力电子应用中具有显著优势,可有效减少器件的串联数量,降低系统成本和复杂度。热导率约为硅的3倍,良好的热导率使得SiC器件在工作过程中能够快速散热,提高器件的功率密度,降低热管理成本。
基于这些优异性能,SiC在轨道交通领域,可用于制造高效的电力变流器,提高列车的能源利用效率和运行速度;在新能源汽车中,能够提升车载充电器和电机控制器的性能,延长电池续航里程;在高压电网里,有助于实现高压直流输电的高效转换和稳定运行;5G通信中,SiC器件可满足基站对高频、高功率器件的需求,提高通信质量和信号覆盖范围;航空航天和国防军事领域,其耐高温、高可靠性的特点使其成为制造飞行器和军事装备关键电子部件的理想材料。
然而,要实现SiC器件的大规模应用,制备高质量、大尺寸、低成本的SiC单晶衬底是关键前提。目前,SiC单晶的生长方法主要有物理气相传输法(PVT)、高温化学气相沉积法(HTCVD)和高温溶液生长法(HTSG,以顶部籽晶溶液生长法TSSG为主),每种方法都有其独特的原理和特点,在SiC单晶生长领域扮演着重要角色。
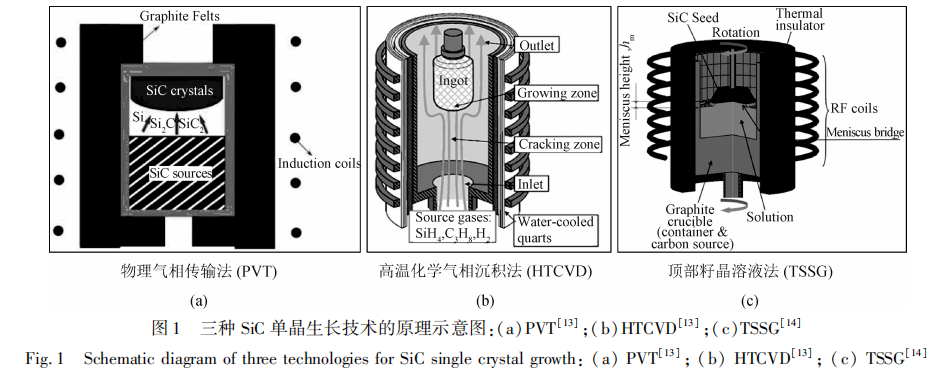
(一)物理气相传输法(PVT)
PVT法是目前发展最为成熟且应用广泛的SiC单晶生长方法。其基本原理是利用多晶SiC粉料在高温下分解,分解后的Si和C原子通过气相传输,在籽晶表面重新结晶,从而实现单晶的生长。这种方法经过多年的发展,技术已经相对成熟,目前6英寸的SiC单晶衬底已实现产业化生产,这为SiC器件的大规模应用提供了一定的基础。
在2016年,美国Cree公司宣称采用PVT法成功生长出8英寸的SiC单晶,这一成果在SiC单晶生长领域具有重要意义,展示了PVT法在大尺寸单晶生长方面的潜力。随着研发的不断深入和技术的持续进步,PVT法生长的SiC晶体中的微管已基本消除,密度小于0.2cm⁻² ,这对于提高SiC器件的性能和可靠性有着积极影响。
PVT法仍然存在一些局限性。其位错密度仍然较高,约为10² - 10⁴ cm⁻² ,高位错密度会严重影响器件的性能和寿命,导致器件的击穿电压降低、漏电流增大等问题。PVT法在扩径方面难度较大,随着晶体尺寸的增大,生长过程中的温度均匀性、气流分布等问题难以有效解决,从而影响晶体的质量和成品率。而且该方法的成品率较低,生产成本较高,这在一定程度上限制了SiC器件的大规模应用和市场推广。
(二)高温化学气相沉积法(HTCVD)
HTCVD法是利用Si源和C源气体在约2100℃的高温环境下发生化学反应,生成SiC并在衬底表面沉积生长,实现SiC单晶的生长。这种方法的一大显著优势是可以实现晶体的长时间持续生长,为制备大尺寸的SiC单晶提供了可能。
通过HTCVD法,已经成功生长出4英寸和6英寸的SiC单晶,并且生长速率可高达2 - 3mm/h,相对较快的生长速率有助于提高生产效率,降低生产成本。HTCVD法也面临一些挑战。它与PVT法一样需要极高的生长温度,高温环境不仅对设备的耐高温性能要求苛刻,增加了设备成本和维护难度,而且在高温下,设备的稳定性和工艺的可控性也面临挑战。
HTCVD法需要用到如SiH₄、C₃H₈和H₂等气体,这些气体大多具有易燃易爆、有毒等特性,在储存、运输和使用过程中需要严格的安全措施,增加了生产的复杂性和成本。由于生长过程中涉及复杂的化学反应和气相传输过程,对工艺的控制要求极高,稍有不慎就可能导致晶体质量下降,进一步提高了生产成本。
(三)高温溶液生长法(HTSG,以TSSG法为主)
HTSG法中的TSSG法是目前备受关注的SiC单晶生长方法。其基本原理是利用Si和C元素在高温溶液中的溶解、再析出来实现SiC单晶的生长。该方法在低于2000℃的温度下,近热力学平衡的状态下进行生长,与PVT法和HTCVD法相比,生长温度相对较低,这不仅降低了对设备耐高温性能的要求,减少了设备成本,而且在近热力学平衡状态下生长,理论上更容易获得高质量的SiC单晶。
TSSG法还具有诸多独特优势。生长的晶体无微管,这是其他方法难以比拟的优势,无微管的晶体结构更加完整,能够有效提高器件的性能和可靠性。生长过程可调控性更强,可以通过精确控制溶液的组成、温度、籽晶和坩埚的旋转提拉速度等参数,实现对晶体生长过程的精细调控,从而获得高质量的晶体。该方法在扩径方面相对容易,为制备更大尺寸的SiC单晶提供了可能。TSSG法还易于实现p型掺杂,这对于制备高性能的SiC器件具有重要意义。
目前,采用TSSG法已成功生长出4英寸的SiC单晶,展示了该方法在SiC单晶生长领域的潜力。随着研究的不断深入和技术的不断完善,TSSG法有望成为继PVT法之后制备尺寸更大、结晶质量更高且成本更低的SiC单晶的方法,为SiC产业的快速发展注入新的活力。
TSSG法研究重点
由于TSSG法具有上述独特优势,近年来受到越来越多研究者的关注。在TSSG法生长SiC单晶过程中,有多个关键因素会影响晶体生长的速率和结晶质量,这些因素是目前的研究重点。
(一)高温溶液的组成与配比是影响晶体生长的关键因素之一。不同的溶液组成和配比会影响Si和C元素在溶液中的溶解度、扩散系数以及化学反应速率,从而直接影响晶体的生长速率和质量。研究合适的溶液组成和配比,能够优化晶体生长过程,提高晶体的质量和生长效率。
(二)坩埚中温场的调控也至关重要。温场的均匀性和稳定性会影响Si和C元素在溶液中的分布和扩散,进而影响晶体的生长速率和结晶质量。不均匀的温场可能导致晶体生长速率不一致,产生晶体缺陷,因此精确调控温场,确保其均匀稳定,是获得高质量晶体的关键。
(三)坩埚的结构设计也不容忽视。合理的坩埚结构可以优化溶液的流动和传热,提高温场的均匀性,有利于晶体的生长。例如,通过设计特殊的坩埚形状和内部结构,可以促进溶液的自然对流,增强Si和C元素的传输,从而提高晶体的生长质量。
(四)籽晶和坩埚的旋转提拉工艺对晶体生长也有重要影响。旋转提拉速度的快慢会影响晶体的生长速率和结晶质量,合适的旋转提拉速度可以使晶体在生长过程中保持良好的结晶取向,减少晶体缺陷的产生。精确控制籽晶和坩埚的旋转提拉工艺参数,是实现高质量SiC单晶生长的重要保障。


