1、滑移线缺陷成因分析
滑移线是外延层表面沿 <110> 方向延伸的线段,滑移线的产生主要是由于位错源在应力作用下产生大量位错,并不断沿原子键密度最小的 <110> 方向延伸,最后滑移出硅片表面。在外延环节,由于反应腔温度分布不均引起热应力,超出了硅的应力极限,而衬底边缘的微损伤会聚集这种应力,导致滑移线更严重。
滑移线缺陷常以正交线、相交线的形式出现。(111)晶面滑移线间呈 60°或 120°夹角,(100)晶面滑移线互为 90°夹角,(110)晶面滑移线则有 54.7°、70.5°、109.5°及 125.2°多种夹角出现。常见的滑移线分布如表 1 所示,与硅片参考面晶向强相关。滑移线宏观特征,包括规则程度、深浅程度、延伸程度、延伸方向,存在较大差异,本文根据可目视程度将不同类型的滑移线分为Ⅰ类(显型)、Ⅱ类(亚型)、Ⅲ类(隐型)。

2、Ⅰ类滑移线检验
Ⅰ类滑移线是最常见的类型,Ⅰ类滑移线典型形貌如图 1 所示,其已经在硅片表面形成明显台阶,且向片内延伸。在显微镜下观察滑移线延伸线的前部,可以看到台阶越来越小且逐渐消失,具有从显型向隐型特征转变的过程。
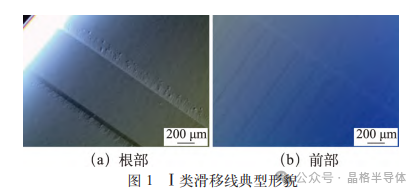
在日光灯下,依靠光线在滑移线不同分界高度处反射产生明暗的视觉效果,从而识别滑移线特征。日光灯下不同检验角度产生了不同的识别效果(如图 2所示),检出能力由强到弱排序为平行、斜向、垂直。平行角度下检验长度较长,可识别前段延长线;斜向角度下检验长度中等,前段延长线不可见;垂直角度下,滑移线未被识别。
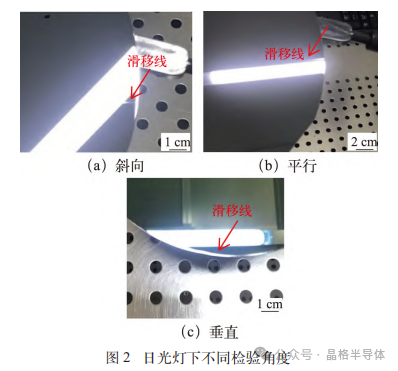
实践过程中发现Ⅰ类滑移线检查结果经常有较大偏差,对产线过程控制造成很大的困扰。以 6 英寸中高压 MOS 典型产品为例,产品衬底晶向为 <100>,参考面晶向为 <110>,常常会出现漏检或总长偏差返工问题。通过上述分析,可以解释某款典型产品漏检返工问题,即 0 点钟方向与 6 点钟方向滑移线可以在第一时间被检验出来,而 3 点钟、9 点钟方向的滑移线极易被漏检,且可见滑移线部分条数与数量的计算往往也偏差较大。
改进日光灯下滑移线目视检验方法,将硅片正面平放在日光灯下,保持日光灯灯管与硅片边缘垂直,目视旋转一周检查硅片表面,滑移线检验时人工取出硅片需依次在 0°与 90° 2 个平面方向旋转一周。
此外,滑移线是大量贯穿硅片的位错的滑移累积起来的效果,造成宏观上由底层延伸到表面的塑性形变,存在一定宽度,外延层表面滑移线宽度如图 3 所示。大量的实践经验表明,显微镜下观察到的宏观单条滑移线基本上由多条滑移线构成,因此滑移线量化计算时需要引入宽度的概念,否则该类型滑移线按不同条数计算会造成检验结果呈倍数偏差,对于密集滑移线区域的量化计算是灾难性的,不同人员计算条数不同,将失去计算意义。引入宽度概念后,在某个确定值区间内的Ⅰ类滑移线按 1 条计算,实践中选择经验值 5 mm 为一个宽度区间,标准量化且唯一,结果精确可靠。
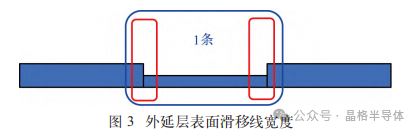
采用改进后的日光灯检验方法得到的检验结果如表 2 所示。检验数据显示,无横向滑移线样品组的滑移线条数无偏差,滑移线总长一致。存在横向滑移线样品组的滑移线条数明显偏差 1~2 条,滑移线总长明显偏差 1~4 cm。斜向滑移线样品组滑移线条数无偏差,滑移线总长偏差 0.5~1.5 cm。其中存在横向滑移线样品组的偏差是无法接受的,部分有滑移线外延片被错判为无滑移线外延片,在实际生产中属于严重漏检。
3、Ⅱ类滑移线检验
Ⅱ类滑移线已经延伸到硅片表面,线状痕迹极淡,尚未形成台阶,在日光灯下无法被识别。但是该类滑移线会伴随着大量面缺陷,根部粗糙,缺陷密度大,中部密度适中,前部密度下降,Ⅱ类滑移线不同部位缺陷密度如图 4 所示。进一步将滑移线中部放大,滑移线方向伴随大量小丘状乳突微缺陷,如图 5 所示,粒径在 10~80 μm 不等,互相堆叠形成一定的高度差与倾斜角。微缺陷大量聚集时,在高强度卤素灯(简称强光灯)下特定角度可被识别,强光灯特定角度下滑移线形貌如图 6 所示。
该类滑移线检验的准确性依赖强光灯的照度以及检验手法。目前行业内基本配置有照度大于 300 000 lx的高强度卤素灯,满足检验照度要求。而常规检验手法是灯下平行观察,目视有较大的局限性与偶然性,导致该类滑移线仅有个别人可检出甚至出现整批无人能够检出的情况。
改进强光灯下滑移线的目视检验方法,将硅片正面垂直于光源照射方向,手动晃动角度大于 20°,围绕灯光晃动并旋转一圈,目视检查硅片边缘。

对缺陷片择优腐蚀 5 μm 后进行镜检,滑移线区域出现大量滑移位错,同时小丘状乳突微缺陷仍存在,形貌与数量均没有减少,缺陷片择优腐蚀后的镜检形貌如图 7 所示。该区域外延层内埋有大量线缺陷以及面缺陷,缺陷密度超过 10 颗 /mm2,对后续器件管芯的危害是致命的,批量生产过程中需要极力避免。通过工艺温度优化调节,可以减轻或消除该类缺陷。
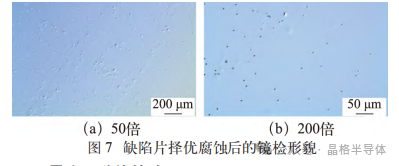
4、Ⅲ类滑移线检验
Ⅲ类滑移线在硅片表面有较浅的规则痕迹,尚未形成明显的台阶,或伴随有少量微缺陷,Ⅲ类滑移线典型形貌如图 8 所示,在日光灯、强光灯下均无法被检出,常规目视法已不适用,需要借助自动检验设备。
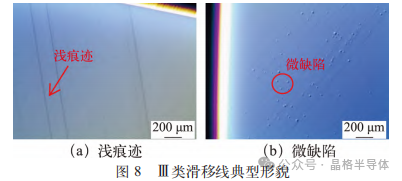
对该类滑移线缺陷片择优腐蚀 5 μm 后镜检分析,规则滑移线痕迹仍然存在,同时伴随少量滑移位错,缺陷密度小于 1 颗 /mm2,该类危害较小。而小丘状微缺陷处同Ⅱ类滑移线一样出现大量滑移位错,且原微缺陷仍存在,形貌与数量均没有减少,因缺陷密度一般小于Ⅱ类滑移线,批量生产时需要评估产品的接收程度。
来源:《大尺寸厚层硅外延片表面滑移线缺陷检验研究》


