单晶硅中砷掺杂和磷掺杂有什么区别?
时间:2025-06-17 发布人:admin 点击数:0
同样是N型半导体,单晶硅中砷掺杂和磷掺杂有什么区别?在单晶硅中,砷(As)和磷(P)均为常用的 N 型掺杂剂(五价元素,提供自由电子),但由于原子结构、物理性质及工艺特性的差异,两者在掺杂效果和应用场景中存在明显区别。
磷(P):原子半径约 1.06 Å,比硅(1.11 Å)略小,掺杂后对硅晶格的畸变较小,引入的应力较低,材料稳定性较好。 砷(As):原子半径约 1.19 Å,大于硅,掺杂后会导致更大的晶格畸变,可能引入更多缺陷,影响载流子迁移率。

磷(P):施主能级离导带底约 0.044 eV,电离能低,常温下几乎完全电离,载流子(电子)浓度与掺杂浓度接近。 砷(As):施主能级离导带底约 0.049 eV,电离能略高,低温下电离不完全,载流子浓度略低于掺杂浓度,高温下(如 300 K 以上)电离效率接近磷。
磷掺杂的硅中,晶格畸变小,电子迁移率更高(约 1350 cm²/(V・s)); 砷掺杂因晶格畸变和缺陷较多,电子迁移率略低(约 1300 cm²/(V・s)),但高浓度掺杂时差异缩小。
磷(P):在硅中的扩散系数较大(如 1100℃时约 1e-13 cm²/s),高温下扩散速度快,适合形成深结(如双极晶体管的发射极)。 砷(As):扩散系数较小(1100℃时约 1e-14 cm²/s),扩散速度慢,适合形成浅结(如 MOSFET 的源漏区、超浅结器件)。
磷(P):在硅中的最大固溶度约为 1×10²¹ atoms/cm³; 砷(As):固溶度更高,约为 2.2×10²¹ atoms/cm³,可实现更高浓度掺杂,适用于需要高电导率的欧姆接触层。
砷的原子质量(74.92 u)远大于磷(30.97 u),离子注入时射程更短,注入深度更浅,适合精确控制浅结深度; 磷注入深度较深,且因扩散系数大,结深控制难度更高。
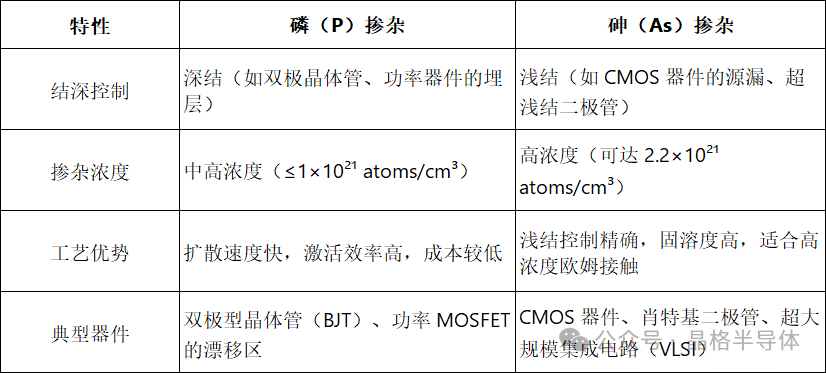
毒性:两者的气态源(如 PH₃、AsH₃)均为剧毒,但 AsH₃的毒性更强(致死浓度更低),工艺处理需更严格的安全措施。 成本:磷源(如 PH₃)的制备和使用成本相对较低,工艺更成熟;砷源因毒性和处理难度,成本略高。


