随着红外光学探测技术向高精度、远距离方向迈进,硅基光探测器凭借其宽光谱响应、良好兼容性及稳定的机械化学性能,成为研究热点。然而,直拉法制备硅单晶时,热应力导致的光学均匀性问题严重制约了其在高性能红外探测系统中的应用。因此,深入研究退火工艺对硅单晶红外光学性能的影响,并探索优化拉晶工艺参数的方法,对提升硅单晶品质意义重大。
退火方式对应力双折射的影响
采用直拉法制备直径超 12 英寸、晶向为 <100> 的硅单晶,从晶圆头尾两端选取样品进行不同退火处理。快速热退火时,硅晶圆片在 2h 内升温至 800°C 并保持 4h,随后以每分钟 5°C 的速率降温;慢速热退火则将降温速率降至每分钟 2°C。

实验结果显示,未退火时硅单晶边缘区域应力双折射高于中心区域,尾部更为显著。快速热退火对降低硅单晶头部应力双折射效果更佳,其边缘应力双折射平均值和差值分别为 1.1602nm 和 3.1785nm;而慢速热退火更适合处理硅单晶尾部边缘,其应力双折射平均值和差值分别为 1.1859nm 和 2.588nm 。
应力双折射分布特征
通过插值拟合技术绘制应力分布图像发现,未退火硅晶圆片整体应力水平高,尾部区域应力双折射值超 5nm;慢速退火后,应力双折射值显著降低,残留应力主要集中在尾部中心,尾部边缘应力得到有效释放;快速退火后,硅单晶头部边缘区域应力双折射表现优于尾部边缘 。虽然快速退火和慢退火对应力双折射的整体影响差异不大,但快速退火能有效改善应力双折射的极值。
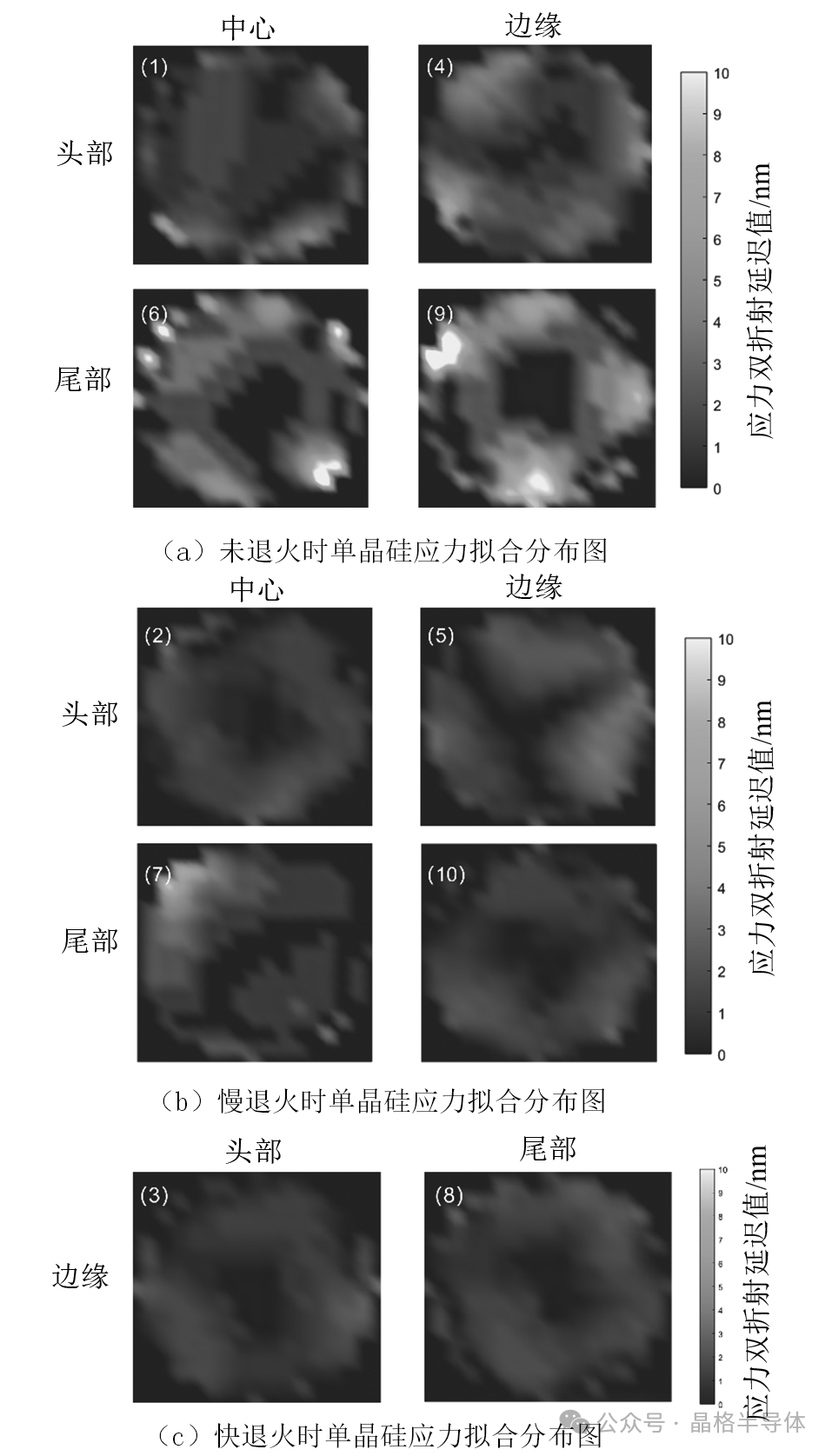
扬州晶格半导体提供高纯度、大尺寸单晶硅、多晶硅、区熔硅,并可定制加工各种类型硅部件、硅片、反射镜、硅透镜、红外硅镜片。17826693981
硅单晶吸收和折射率特性研究
利用傅里叶红外光谱仪对硅单晶样品进行测试,结果表明:直拉法生长的硅晶体在 3 - 5μm 近红外透射率稳定在 50%,9μm 附近存在由本征晶格吸收带和间隙氧气吸收带叠加形成的强吸收峰,这是由于石英坩埚溶解引入了氧杂质。在红外波段反射谱中,3 - 5μm 近红外存在尖峰,暗示该阶段可能存在吸收,7μm 之后反射率逐渐下降至 30% 左右。

根据菲涅尔反射公式,结合硅单晶的透射率和反射率,计算得出其在近红外波段(3 - 5μm)折射率逐渐升高后下降,在中红外波段(10 - 20μm)稳定在 3 左右。在 3 - 5μm 波段,由于硅单晶的吸收作用,出现折射率突降现象。
硅单晶近红外波段光学均匀性研究
应力双折射与应力之间的关系可通过一系列方程描述,包括平衡方程、应变位移方程、本构方程等。在给定边界条件下,可确定应力张量,进而通过抗渗张量与应力张量的关系,得出应力导致的折射率椭球上的折射率变化,最终计算出应力双折射。
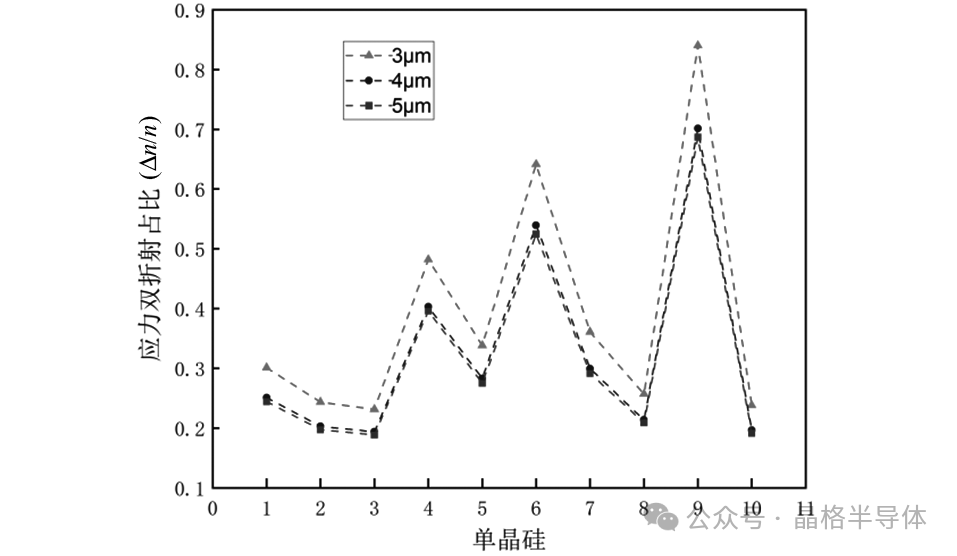
光学均匀性以应力双折射与折射率比值衡量,该比值越低,光学均匀性越高。研究发现,在头部尾部中心,慢退火工艺能有效改善应力双折射,大幅提高光学均匀性;在头部尾部边缘,快速和慢速退火工艺对光学均匀性的改善效果差异不大。尾部的折射率和应力双折射整体大于头部,边缘区域的应力双折射和光学均匀性较差。在不同波段中,4μm 和 5μm 波段光学均匀性较好且差异不大,3μm 波段附近光学均匀性明显降低,降幅接近 50%,这主要是因为 3μm 波段折射率显著下降。
热退火是改善硅单晶光学均匀性的有效手段,快速退火和慢速热退火效果相近,但慢速热退火在减少热应力、避免引入新缺陷方面更具优势。拉晶工艺中,精确控制拉晶速度、固液面凹凸程度以及横向纵向温度差,可有效减少热应力产生。应力双折射在硅单晶的尾部和边缘区域最大,会形成应力环。光学均匀性不仅受应力双折射影响,还与硅单晶本身的折射率相关,且在不同近红外波段存在差异。未来研究可进一步探索更精细的退火工艺和拉晶参数优化方案,以实现更高品质硅单晶的制备,满足日益增长的红外探测技术需求。


