等离子轰击对单晶硅的影响
时间:2025-03-10 发布人:admin 点击数:0
在半导体和光伏产业蓬勃发展的当下,单晶硅凭借其卓越的电学、光学和力学性能,成为支撑现代科技发展的关键材料。从高效的太阳能电池到先进的集成电路,单晶硅都发挥着不可替代的作用。随着技术的不断进步,对单晶硅表面性能的要求也日益严苛。如何精准调控单晶硅表面的物理特性,提升其综合性能,成为科研人员不懈探索的重要课题。低能等离子体轰击技术,作为一种新兴的表面处理手段,为优化单晶硅表面性能带来了新的可能。等离子体刻蚀技术近年来在半导体和光伏领域应用广泛,它通过在磁控溅射装置中施加电压,使惰性气体电离产生离子流,进而对基底表面原子进行轰击和溅射。过往研究表明,氩等离子体刻蚀能够去除基底表面杂质,调整表面形貌和原子分布,提升基底性能。然而,目前多数研究忽略了短时间刻蚀(5min 以内)及刻蚀后保存时间对硅片表面性能的影响。本研究聚焦于此,深入探究低能等离子体轰击参数对单晶硅表面物理性能的影响,为相关工艺改进提供关键实验依据和理论支持。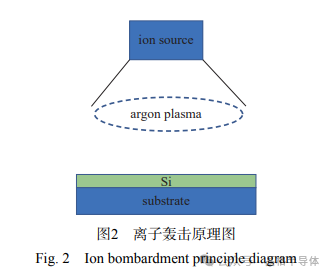
实验选用单面抛光的 10mm×10mm 单晶硅片,刻蚀前,硅片需依次在丙酮、异丙醇、乙醇和去离子水中超声清洗 15min,再用氮气吹干,以彻底清除表面有机物和杂质。刻蚀过程在自主搭建的磁控溅射装置中完成,该装置配备成都金雅电气有限公司生产的 YJM 阳极膜线性离子源。实验主要从刻蚀深度、表面粗糙度、拉曼光谱和润湿性四个方面对硅片表面性能进行表征。利用轮廓仪测量硅片表面刻蚀深度和线粗糙度,通过 3σ 原则剔除异常数据;采用拉曼光谱仪,设置 532nm 可见光激光器、1800 刻线 / 毫米光栅、50% 激光器功率、50× 长焦物镜、10s 积分时间和 3 次扫描次数,对样品表面进行测量;使用接触角测量仪,在硅片表面刻蚀区滴加 5μL 常温去离子水,检测水滴角;借助原子力显微镜(AFM)观测部分刻蚀硅片的表面形貌,并与轮廓仪测量结果相互验证。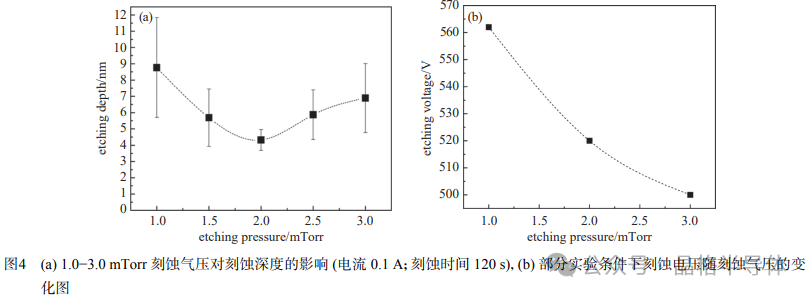
实验结果显示,刻蚀时间对硅片刻蚀深度影响不显著,在不同刻蚀时间下,刻蚀深度在一定范围内波动。随着刻蚀气压的增加,刻蚀深度先减小后增大。这是因为气压增大时,等离子体密度增大,氩离子与氩气分子碰撞概率增加,影响其传输距离,导致刻蚀深度变化。当气压达到一定值后,离子碰撞趋于饱和,更多离子仍能刻蚀硅片,使得刻蚀深度又有所增加。扬州晶格半导体提供高纯度、大尺寸单晶硅、多晶硅、柱状晶,并可定制加工各种类型硅部件、硅锭、硅棒、硅聚焦环、硅管、硅筒。17826693981
硅片表面粗糙度随刻蚀时间和刻蚀气压的增加均呈现先增大后减小的趋势。刻蚀初期,离子刻蚀去除表面二氧化硅,由于去除不均匀,表面粗糙度增大;后期,小撞击坑重叠,表面逐渐光滑,粗糙度减小。刻蚀气压增加时,氩离子注量变化会影响粗糙度,注量较小时粗糙度增大,中等时略微减小,较大时大幅降低。在电流 0.1A、气压 2mTorr 的条件下,刻蚀时间为 10 - 60s 的硅片拉曼二阶峰随刻蚀时间增加而降低。这主要是因为刻蚀时间增加使硅片表面 Si - Si 化学键减少,缺陷增加,拉曼可检测到的信号减弱,但过程中未产生新的特征峰,表明轰击离子未与硅片发生反应。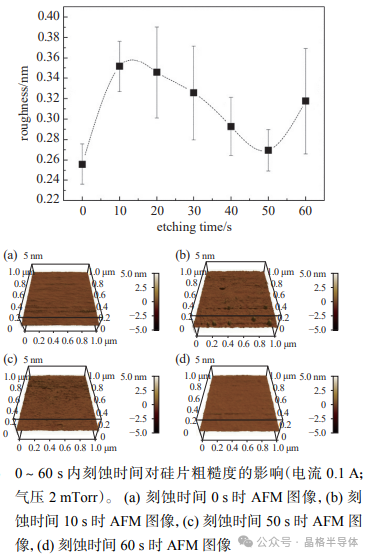
氩等离子体轰击可减小单晶硅表面润湿性。刻蚀后的硅片在气体环境中放置一段时间后,水滴角会大幅增加,甚至发生由亲水性到疏水性的转变。氮离子刻蚀的硅片也有类似趋势,且基本排除保存气体环境对润湿性的影响。推测是低能等离子体轰击使硅片表面形成微观结构,长时间储存后,表面空隙被小分子空气填充,导致水滴与硅片表面实际接触面积减小,水滴角上升。低能等离子体轰击为优化单晶硅表面性能提供了新途径。通过精准控制刻蚀时间和气压等参数,可在不显著影响硅片厚度的前提下,有效改善表面粗糙度,调控表面润湿性,且不会引入新杂质。未来,随着研究的深入,低能等离子体轰击技术有望在单晶硅表面处理领域得到更广泛应用,进一步推动半导体和光伏产业的发展,助力相关领域技术实现新的突破,为高性能电子器件和高效太阳能电池的制备提供更坚实的材料基础。